
关键字:意法半导体 ST THELMA MEMS
意法半导体公司推出一系列惯性传感器,极具诱惑力的价格配合卓越的产品性能,让意法半导体迅速扩大了在消费电子MEMS传感器市场的份额。公司在MEMS技术特性上实现了两全其美:更小尺寸、更低价格、更高性能、更多功能(技术推动)与更具创新力的设计方法(设计推动的创新) ,使最终的MEMS器件更适合消费电子市场的需求[1]。
这个战略已经取得巨大成功,意法半导体因此而迅速崛起,成为世界最大的MEMS器件制造商。目前意法半导体的MEMS产品被世界知名的消费电子产品选用,如任天堂的Wii游戏机、苹果的iPhone手机和iTouch播放器以及其它产品[2]。例如,任天堂的Wii游戏机的遥控器“魔棒”(图1a)使用意法半导体的惯性传感器检测玩家的动作,如打网球、高尔夫球或其它游戏,使玩家能够沉浸在游戏之中并参与屏幕上的人物运动。这个功能促使先进的计算机游戏取得巨大飞跃,从纯粹的被动活动转化为令人兴奋的主动的游戏参与者。同样地,苹果的iPhone采用意法半导体的MEMS传感器检测手持通信设备相对于用户视野的方向,然后相应地调整屏幕的显示方向(横向或纵向),从而为用户提供更多的使用灵活性和功能 (图1b)。

图 1:这两张图片中的产品采用意法半导体的惯性传感器技术,在消费电子产品中为客户提供全新的功能(来源:iSuppli市调公司)。
意法半导体的MEMS惯性传感器基于意法半导体的微致动器和加速计的厚外延层制程(THELMA),如图2 [3]所示。THELMA是一个非集成化的MEMS制造程,比多晶硅表面微加工制程略复杂,但是拥有独特的优点,准许实现较厚的结构,这对电容式惯性传感器极其有用。虽然THELMA制程用于实现电容式惯性传感器,但是这项技术非常灵活,还可以用于制造加速计、陀螺仪和其它的MEMS器件。
这个制程的第一个步骤是在晶圆上生成一层2.5μm厚的热二氧化硅(图2a)。第二步是用LPCVD沉积一个多晶硅层(多晶硅层1)。在这个多晶硅层上做版图然后蚀刻,制成埋入式电连接结构,用于传感器向外部传递电位和电容信号(图2b)。根据器件的设计,这个多晶硅层还可用于制造薄多晶硅微加工器件的结构层。然后,用PECVD沉积一层1.6μm厚的二氧化硅层。这个PEVCD氧化层与2.5μm厚的热二氧化硅构成一个4.1μm厚的复合氧化层,用作THELMA制程中的牺牲层。然后,在PECVD沉积氧化物层上做版图和蚀刻,用作厚多晶硅器件的锚定区,稍后制成锚定组件(图 2c)。下一步,用外延沉积法沉积一层厚多晶硅 (图2d)。这个层的厚度可以根据器件设计做相应的调整,厚度范围是15μm到50μm。通过沉积、版图和蚀刻工艺,制作一个连接传感器的金属导电层(图2e)。随后,用深反应离子蚀刻方法(DRIE)在厚多晶硅层上做图和蚀刻,一直到底部的氧化层(图2f)。DRIE方法准许在厚多晶硅层上制作纵横比很大的结构。最后用氢氟酸蒸汽去除牺牲层,释放多晶硅结构层(图2f)。
意法半导体率先投入量产的低成本封装方法是意法半导体惯性传感器的主要特色之一。如前文所述,MEMS器件的封装很可能是产品制程中最昂贵的环节。意法半导体的封装方法是使用一个玻璃粉低温晶圆级键合工艺,把惯性传感器封闭在两颗晶圆之间的密闭空腔内,然后再使用一个格栅阵列(LGA)封装平台技术封装芯片,意法半导体率先将这项封装技术用于最后的器件封装。在这个过程中,可以把单个的传感器裸片放在半导体裸片的旁边(并列结构)或把传感器裸片和半导体裸片相互堆叠放置(堆叠封装),如图3所。
在堆叠结构中,先用胶合膜将传感器裸片焊到一个表面积很大的基片上(图4)。半导体裸片和MEMS裸片堆叠放置可使封装变得很小(图5)。使用丝焊方法连接两颗裸片的电触点,然后,再用注塑封装技术封装裸片。这种封装方法可以在大面积的基片完成,因此成本相对较便宜。封装应力特别是粘接和注塑过程产生的应力曾经是这项封装技术的一大挑战,意法半导体成功地解决了这个难题。图6描述了意法半导体的超紧凑型线性加速计封装的进化历程,线性加速计广泛用于消费电子产品。
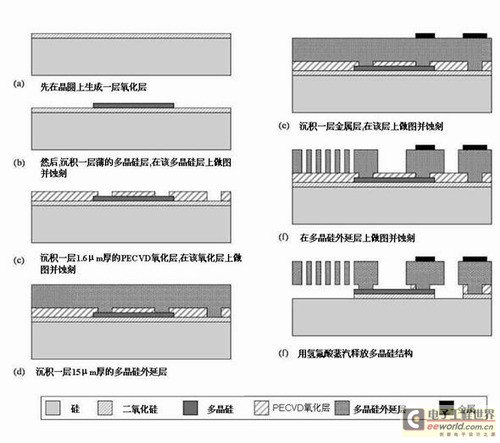
图 2:意法半导体用于制造惯性传感器的THELMA制程工艺
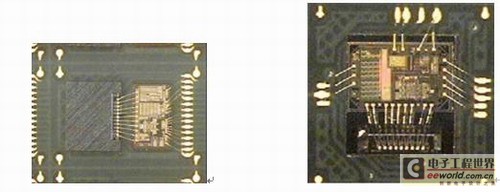
图 3:意法半导体的两种惯性传感器封装结构:(左) 并列封装;(右)芯片堆叠封装
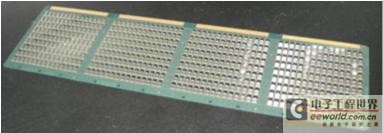
图 4:意法半导体的的低成本薄型MEMS惯性传感器封装。
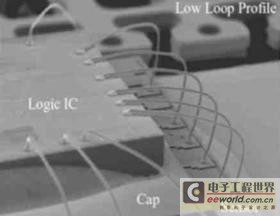
图 5:在采用注塑封装方法前利用丝焊方法把半导体芯片与下面的MEMS传感器裸片连接在一起的堆叠结构的SEM图像。

图 6:意法半导体惯性传感器封装的进化历程图
参考文献
[1] B. Vigna, “MEMS Epiphany,” MEMS 2009 Conference, Sorrento Italy, January
26, 2009.
[2] Source, iSuppli Corporation, See: http://www.isuppli.com
[3] B. De Masi and S. Zerbini, “Process builds more sensitive structures,” EE Times, November 22, 2004.


 在线客服
在线客服
